手机主板
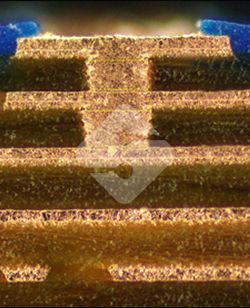
工艺展示
| 层数 | 10L |
| 产品结构 | 2+6+2 |
| 板厚 | 0.7mm |
| 材料 | EM-285 |
| 线宽/线距 | 0.05/0.05mm |
| 最小激光钻孔孔径 | 0.1mm |
| 表面处理 | 沉金+OSP |

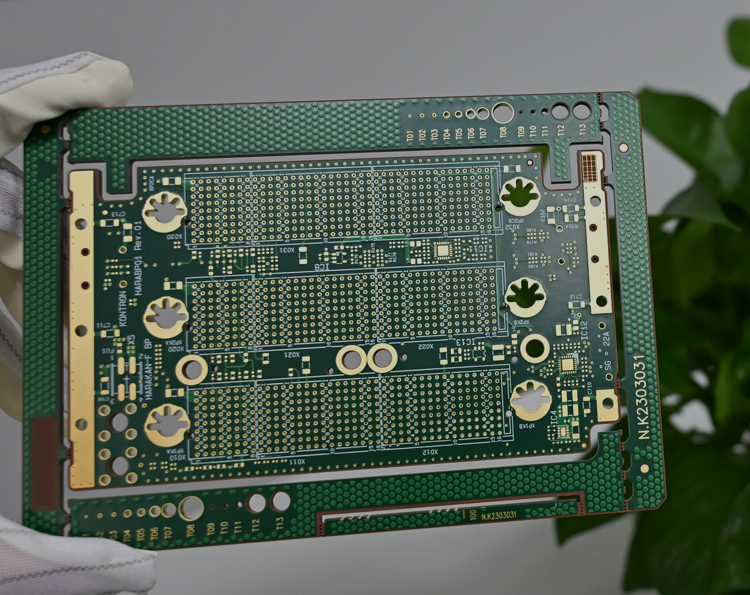
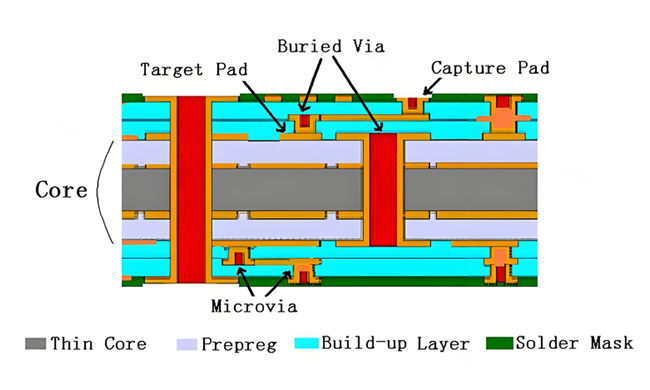
HDI作为高密度互连技术的核心载体,专注于解决电子设备微型化与高性能化的互联需求。其通过微盲孔、40/40μm精细线路及叠孔(Stack via)、填孔(Copper fill)等工艺实现超高密度布线,使元器件在紧凑空间内达到最优布局。该技术具备任意层互连(ELIC)、高纵横比微孔加工及卓越信号完整性控制能力,可有效提升高频性能并减少干扰。江门二厂已成功开发10L/12L ELIC、2+N+N+2、4+N+4等先进结构,广泛应用于智能手机、高端穿戴设备及医疗微系统等领域,持续推动电子产品向轻薄化、多功能化发展。
江门二厂产品主要应用于手机、平板和LED等领域
查看详情